引言
GaN和InGaN基化合物半导体和其他III族氮化物已经成功地用于实现蓝-绿光发光二极管和蓝光激光二极管。由于它们优异的化学和热稳定性,在没有其它辅助的情况下,在GaN和InGaN基材料上的湿法蚀刻是困难的,并且导致低的蚀刻速率和各向同性的蚀刻轮廓。
用于GaN基材料的干法蚀刻威廉希尔官方网站 显示出各向异性的蚀刻轮廓和快速的蚀刻速率。众所周知,使用ECR等离子体蚀刻可以获得比RIE蚀刻更高程度的各向异性轮廓和更快的蚀刻速率,因为ECR的等离子体密度更高。
实验与讨论
我们通过使用厚度为2-3μm的未掺杂GaN和n-GaN样品、厚度为1μm的p-GaN样品和InGaN激光器来进行实验,其结构都是通过金属有机化学气相沉积(MOCVD)在c面蓝宝石衬底上生长的。图1描绘了InGaN激光器结构的示意图。在制作Ni掩模之后,将GaN样品放置在与ICP反应室相连的负载锁定室中进行蚀刻。
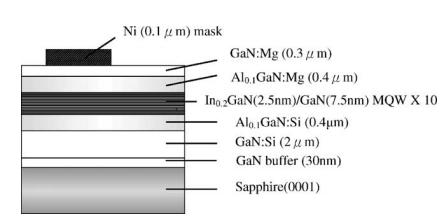 图1:激光器结构示意图
图1:激光器结构示意图
我们研究了Cl2和Ar气体流量对未掺杂GaN的刻蚀速率和表面形貌的影响。在蚀刻过程中,Ar流速保持在25sccm,并且可以观察到,在Cl2为10 sccm时,表面粗糙度具有较低值0.2nm,并且随着Cl2流速的增加没有大的变化。似乎蚀刻速率随着Cl2流速的增加而增加,因为等离子体中Cl自由基的浓度更高。
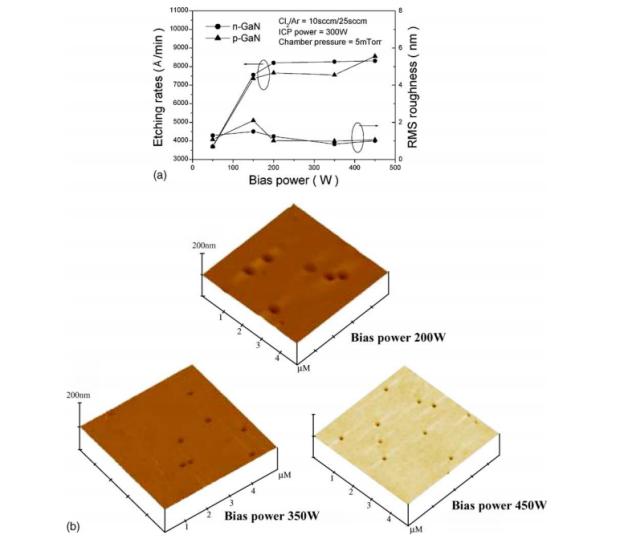 图2
图2
在5毫托的室压、300W的ICP源功率和10sccm Cl2/25sccm Ar的相同气体混合物下,n-GaN和p-GaN蚀刻速率和rms粗糙度作为偏压功率的函数如图2所示。n-GaN和p-GaN的刻蚀速率随着偏压功率的增加而单调增加,超过200 W后趋于稳定。
随着偏压功率的增加,离子轰击能量增加,导致蚀刻速率增加。然而,均方根粗糙度相当平滑,约为1nm,并且与高达200 W的偏置功率无关。
在我们的实验中,坑密度在200 W的偏压下约为2.4×109 cm2,在350 W时约为3.2×109 cm2,在450 W时约为4×1010cm2。当ICP功率和偏压功率分别固定在300、100 W时,蚀刻速率随着室压从2.5毫托增加到40毫托而增加,并达到约12000/分钟的较大蚀刻速率。
蚀刻速率的增加表明在低于40毫托的室压下反应物受限。然而,在超过40毫托的较高室压下,由于复合导致较低的等离子体密度,蚀刻速率逐渐降低。
结论
英思特使用镍掩模在Cl2/Ar电感耦合等离子体中对未掺杂的n-GaN、p-GaN和InGaN激光器结构进行干法刻蚀。当Cl2/Ar气体流速固定在10/25sccm时,对于未掺杂的GaN,在恒定的ICP/偏置功率,300/100W和5毫托室压下,蚀刻表面粗糙度具有最低值0.2nm。
表面粗糙度取决于偏置功率和室压,并且对于n-GaN和p-GaN,在50W的偏置功率下,显示出约1nm的低rms粗糙度值。为了使用高Cl2流速和5毫托的低室压蚀刻InGaN激光器结构,英思特通过ICP系统获得InGaN激光器结构的光滑镜面状小面。使用这些蚀刻参数,可以获得可用于制造基于氮化物的激光二极管的镜面状小面。
审核编辑:汤梓红
-
半导体
+关注
关注
334文章
27305浏览量
218194 -
晶圆
+关注
关注
52文章
4895浏览量
127940 -
氮化镓
+关注
关注
59文章
1629浏览量
116310
发布评论请先 登录
相关推荐
如何对氮化镓基发光二极管结构进行干法刻蚀

氮化镓的蚀刻速率与氩离子电流的关系
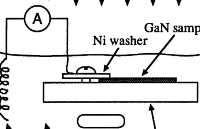
反应离子蚀刻的实用方法报告
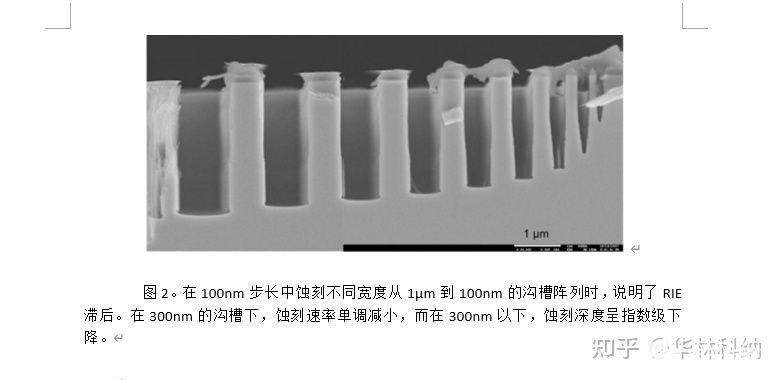
关于微威廉希尔官方网站 中硅反应离子刻蚀的研究
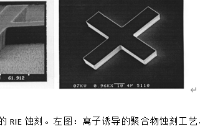




 基于电感耦合反应离子刻蚀的氮化镓干蚀研究
基于电感耦合反应离子刻蚀的氮化镓干蚀研究


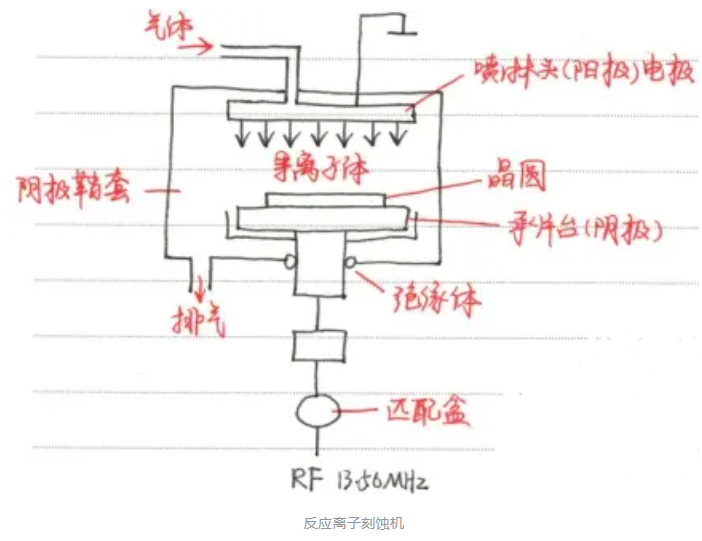













评论