低温无压烧结银对镀层的四点要求
对于AMB基板、DBC基板以及底板来说,铜或铝表面在空气中会发生氧化,形成的氧化物薄膜会阻碍与低温烧结银之间的原子扩散和金属键的形成,降低连接强度。为避免基板表面的氧化,提升与互连材料之间的连接强度,需要对基板进行金属镀层处理。AS9376低温无压烧结银对镀层要求有以下四点
1、扩散层稳定
AMB基板、DBC基板以及散热器表面的金属镀层通常具有基板与互连材料之间的热导通、机械连接和电气连接这三个功能。需要形成金属镀层与基板之间的原子扩散,形成原子结合。该连接需要在AS系列烧结银互连过程中稳定,需要在可靠性测试:比如温度循环测试,高低温测试等测试中保持高剪切强度的连接,并且具有较低的界面热阻。
2、润湿性好
随着第三代半导体器件向高温、大功率方向的发展,AMB基板、DBC基板以及散热器表面的金属镀层需要满足高结温可靠性的要求。需要对互连材料具有良好的润湿性,来形成无空洞连接层。金属镀层表面需要避免产生氧化物或氮化物,避免底层的元素扩散到表面造成污染。
3、电阻和热阻尽量低
导电和导热性能需要具有尽量低的界面电阻和界面热阻,来保证良好的导电和导热性能;
4、金属间化合物尽量少
需要尽量避免产生金属间化合物。金属间化合物一般为脆性,三元金属间化合物比二元金属间化合物更脆,易导致可靠性问题。如不能避免,需要尽量形成较薄的、不连续的金属间化合物层。
低温烧结银焊膏AS系列,具有低温烧结,高温服役的特点,AS9376无压烧结银具有:低温烧结,较高的熔点,热导率高,导电率好和高可靠性等性能,可以应用于耐高温芯片的互联。
低温无压烧结银可以实现高强度的低温烧结银的互连,可以无需额外的热压设备,大大降低生产成本,这对于拓展烧结银互连材料和威廉希尔官方网站
具有非常重要的理论和应用价值。
审核编辑 黄宇
-
半导体
+关注
关注
334文章
27305浏览量
218155 -
DBC
+关注
关注
2文章
55浏览量
7766 -
AMB
+关注
关注
0文章
21浏览量
6007
发布评论请先 登录
相关推荐
烧结银在卫星互联网中的四大应用
烧结银胶成为功率模块封装新宠
烧结银AS9378火爆的六大原因
无压封装的力量:纳米银威廉希尔官方网站 引领未来电子

基于低温焊料的真空烧结工艺研究
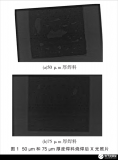
碳化硅模块使用烧结银双面散热DSC封装的优势与实现方法
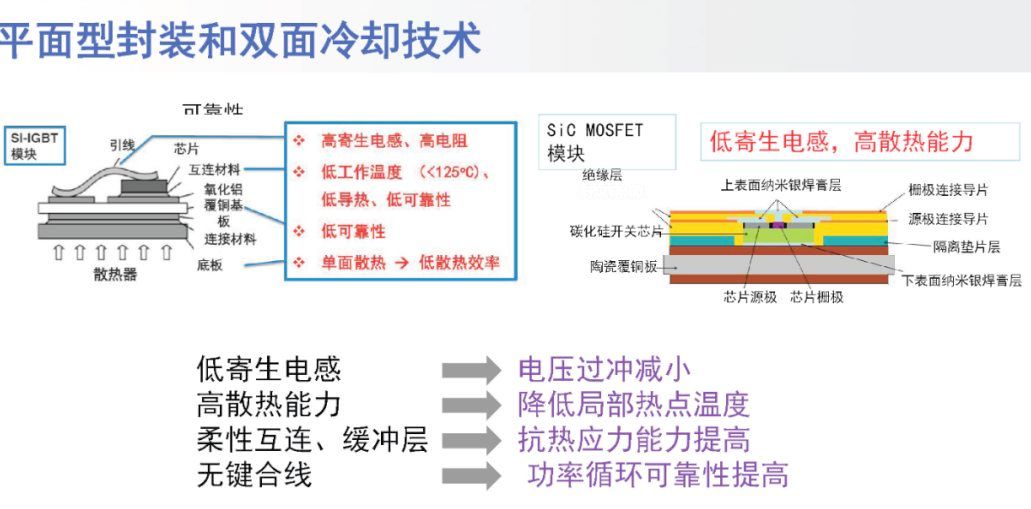
晶圆级封装用半烧结型银浆粘接工艺





 低温无压烧结银对镀层的四点要求
低温无压烧结银对镀层的四点要求


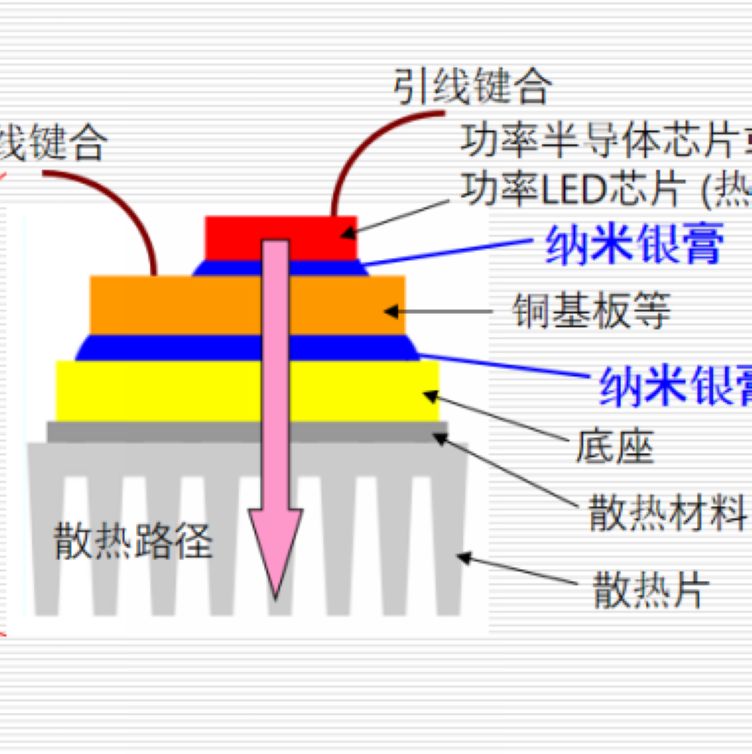











评论