原子层沉积 (AtomicLayer Deposition, ALD)是指通过单原子膜逐层生长的方式,将原子逐层沉淀在衬底材料上。典型的 ALD 采用的是将气相前驱物(Precursor)交替脉冲式地输人到反应器内的方式。
例如,首先将反应前驱物 1通入到衬底表面,并经过化学吸附,在衬底表面形成一层单原子层,接着通过气泵抽走残留在衬底表面和反应腔室内的前驱物1;然后通入反应前驱物2到衬底表面,并与被吸附在村底表面的前驱物1 发生化学反应,在耐底表面生成相应的薄膜材料和相应的副产物;当前驱物1完全反应后,反应将自动终止,这就是 ALD 的自限制 (Self-Limiting)特性,再抽离残留的反应物和副产物,准备下一阶段生长;通过不断重复上述过程,就可以实现沉积逐层单原子生长的薄膜材料。
ALD与 CVD 都是通入气相化学反应源在衬底表面发生化学反应的方式,不同的是 CVD 的气相反应源不具有自限制生长的特性。由此可见,开发ALD 威廉希尔官方网站
的关键是寻找具有反应自限制特性的前驱物。
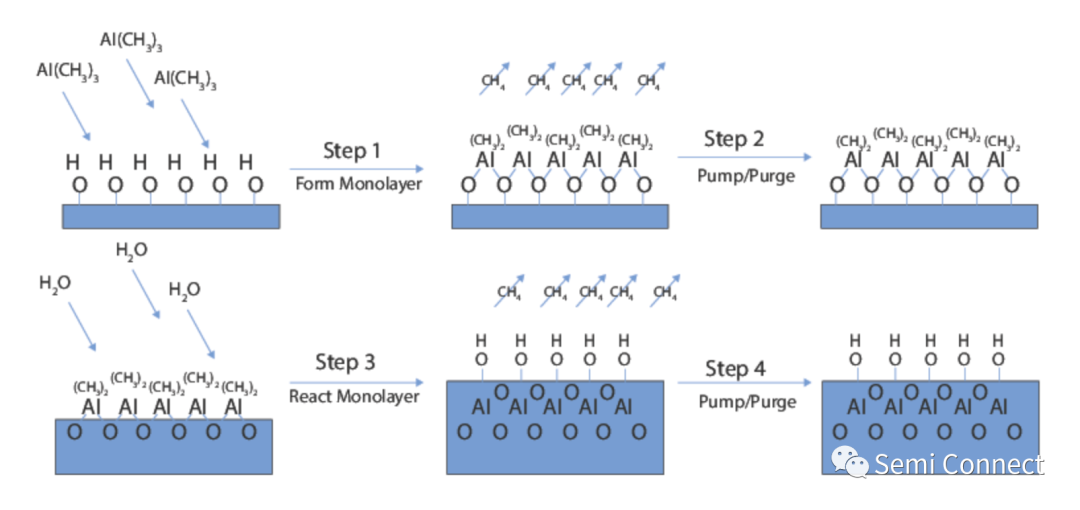
由于 ALD 威廉希尔官方网站
逐层生长薄膜的特点,所以 ALD 薄膜具有极佳的合阶覆盖能力,以及极高的沉积均匀性和一致性,同时可以较好她控制其制备薄膜的厚度、成分和结构,因此被广泛地应用在微电子领域。尤其是 ALD 具有的极佳的台阶覆盖能力和沟槽填充均匀性,十分适用于棚极侧墙介质的制备,以及在较大高宽比的通孔和沟槽中的薄膜制备。
ALD 威廉希尔官方网站
在产业中的主要应用领域为栅极侧墙生长、高k栅介质和金属栅(Metal Gate)、铜互连工艺中的阻挡层 (BarierLayer)、微机电系统(MEMS)、光电子材料和器件、有机发光二极管 ( OrganieLight Eimiting Diode, OLED)材料、DRAM 及 MRAM 的介电层、嵌人式电容、电磁记录磁头等各类薄膜。
随者集成电路的发展,器件的尺寸越来越小,生长的薄膜厚度不断缩小且深槽深宽比不断增加,使得 ALD 威廉希尔官方网站
在先进威廉希尔官方网站
节点的应用越来越多,如从平面器件转到 FinFET 器件后,自对准两次曝光威廉希尔官方网站
的侧墙采用 ALD 威廉希尔官方网站
生长;从多晶硅栅转向高k介质金属栅威廉希尔官方网站
,高k介质和金属栅叠层生长过程也采用了 ALD 威廉希尔官方网站
。
审核编辑 :李倩
-
原子
+关注
关注
0文章
88浏览量
20292 -
反应器
+关注
关注
2文章
97浏览量
11049
原文标题:原子层沉积(Atomic Layer Deposition,ALD)
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
原子层沉积ALD威廉希尔官方网站 实现边缘钝化,TOPCon电池效率提高0.123%

选择性沉积威廉希尔官方网站 介绍
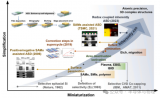
OSI七层模型中各层的协议 OSI七层模型的优势与不足
浅谈薄膜沉积
最新Science:原子层沉积威廉希尔官方网站 在钙钛矿太阳能电池中沉积锡氧化物(SnOx)以提高其长期稳定性的研究

周星工程研发ALD新威廉希尔官方网站 ,引领半导体工艺革新
中微推出自研的12英寸原子层金属钨沉积设备Preforma Uniflex AW
江苏鲁汶仪器股份有限公司揭示原子层刻蚀新方法
苹果测试新抗反射涂层威廉希尔官方网站 ,提升iPhone相机成像水平
流量控制器在半导体加工工艺化学气相沉积(CVD)的应用

原子力显微镜AFM测试与案例分享
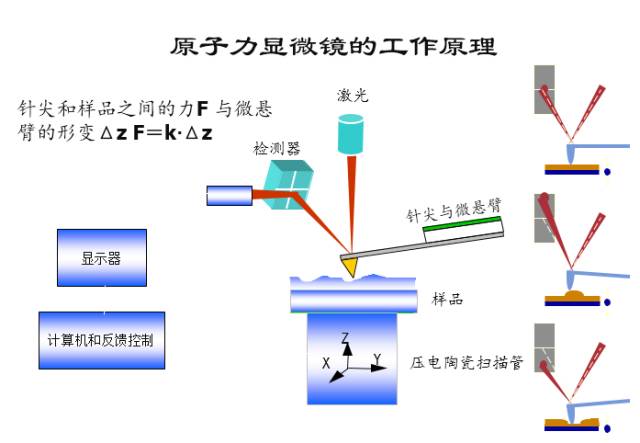




 原子层沉积(Atomic Layer Deposition,ALD)
原子层沉积(Atomic Layer Deposition,ALD)
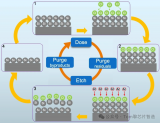
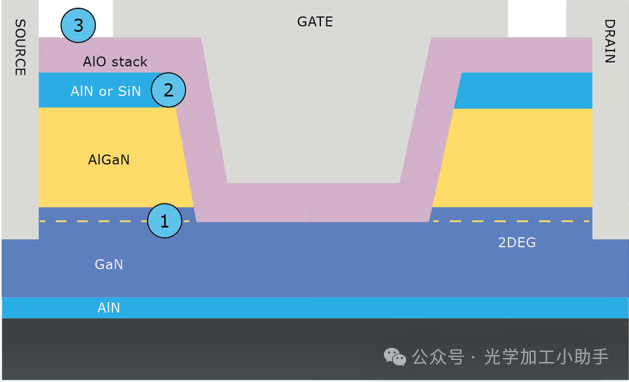











评论